Atomi rétegleválasztás
| Nanotechnológia Nanolitográfia és egyéb kapcsolódó eljárások |
|---|
|
Rétegleválasztás: Vékonyréteg-leválasztás, Kémiai gőzfázisú leválasztás, Atomi rétegleválasztás, Fizikai gőzfázisú leválasztás, Katódporlasztás, Vákuumpárologtatás, Impulzuslézeres leválasztás Felületmódosítás: Fókuszált ionnyalábos porlasztás, Reaktívion-marás, |
| Szakterületek |
|
Anyagtudomány, Szilárdtestfizika, Atomfizika, Mezoszkopikus fizika, Felületfizika, Félvezetők |
| Alapjelenségek |
|
Nanoszerkezet, Kvantumbezárás, Van Hove-szingularitás, Kétdimenziós elektrongáz, Ballisztikus vezetés, Önszerveződés, Alagúthatás |
| Eljárások |
|
Nanolitográfia, Atomerő-mikroszkóp, Pásztázó alagútmikroszkóp, Pásztázó elektronmikroszkóp, Transzmissziós elektronmikroszkóp, Mágneses magrezonancia |
|
A Wikimédia Commons tartalmaz Nanotechnológia témájú médiaállományokat. |
Az atomi rétegleválasztás (angol rövidítéssel ALD, atomic layer deposition) egy vékonyréteg-elválasztási módszer a mikro- és nanotechonlógiában. Az eljárás során gáz fázisban végbemenő kémiai reakciók segítségével atomi rétegenként alakítják ki egy hordozó felületén a vékonyréteget.
Gyakran alkalmazott megvalósítása az ALCVD (atomic layer chemical vapor deposition), mely a kémiai gőzfázisú leválasztások csoportjába tartozik.
Mechanizmusa[szerkesztés]
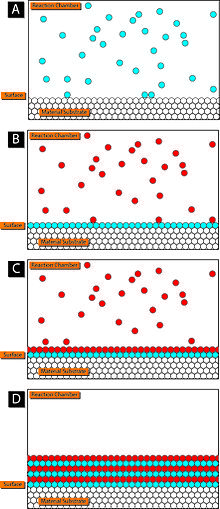
Az eljárás jellemző kialakításában a hordozófelületet egymást váltva, kétféle hordozóanyaggal hozzák kapcsolatba.[1] A felület, amin a vékonyréteg felépül, tehát mindig egyféle anyagnak van kitéve. Az ALD eljárások közös jellemzője, hogy az egyes lépésekben a réteg épülése önszabályozó. Ennek hátterében jellemzően az áll, hogy a felületen csak véges számú „kapcsolódási pont” található a beeresztett anyagok molekulái számára, amelyek betelése után a réteg egy atomnyi vagy molekulányi épülése után e folyamat leáll. Az egymást követő expozíciók állítják elő a jól szabályozott rétegszerkezetet.
Az egyes expozíciós fázisokat kiürítési fázisok követik, amikor a felesleges hordozógázok távoznak a reaktorból. A réteg hibamentessége a jól megválasztott expozíciós és kiürítési időkkel javítható. Egy kétkomponensű atomi rétegleválasztás esetén az expozíció, kiürítés, majd a másik anyaggal történő expozíció és újbóli kiürítés együttese alkot egy rétegleválasztási ciklust. Az ALD folyamatban a rétegépülés jellemző paramétere a ciklusonkénti rétegépülési ráta (szemben például a CVD-vel, ahol a rétegépülés időegységenkénti rátáját adják meg).[2]
Az expozíciós időt úgy kell megválasztani, hogy a felület telítődése a lépésben a lehető legteljesebb legyen, azaz egyenletes felületi borítás alakuljon ki. A hordozógáz, vagy -folyadék áramlási jellemzői (nyomása, árama), illetve a molekulák megtapadási valószínűsége alapvetően befolyásolja a szükséges expozíciós időt. Az egységnyi felületre vett abszorpciós ráta az alábbiak szerint fejezhető ki az S megtapadási valószínűséggel és az F beérkező moláris fluxussal (felületegységen, időegységen érkező mólok számával):[3][4]
.
Egy expozíciós lépésben S a megtapadó molekulák számával összefüggően csökken, míg nulla nem lesz a telítődéskor.
A fenti általános jellemzőkön túl az expozíciós lépések kémiai jellege igen sokféle lehet attól függően hogy milyen hordozóanyagokból, hány lépéses ciklusban milyen réteget alakítanak ki. Ezek közül a gyakori alkalmazásuk miatt nevezetes az alumínium-oxid termikus leválasztása,[5] a fémes vegyületek atomi leválasztása,[6] illetve a katalitikus szilícium-dioxid-leválasztás.[7]
Jellemzői[szerkesztés]
Az ALD fő előnye, hogy jól kontrollált eljárásban atomi méretekig pontosítható a rétegvastagság, illetve az egymást követő rétegek is jól definiáltak lesznek. Ezért nélkülözhetetlen vékonyréteg-leválasztási módszere egyes mikro- és nanotechnológiai eljárásoknak, ahol a méretek, a rétegszerkezet és az összetétel jelentősége kimagasló. A kémiailag katalizált reakciók miatt további előnyt jelent a jellemzően alacsony, akár szobahőmérsékletű leválasztási hőmérséklet is. Ez segít a nanoeszköz, illetve a hordozó védelmében, és csökkenti a szennyeződés veszélyét, biológiai minták esetében pedig nélkülözhetetlen. Technikai előnyt jelent, hogy a lassú eljárásban olyan hordozóanyagok is alkalmazhatók, melyek reakcióideje igen lassú.[7]
Az ALD hátrányait jellemzően a körülményessége okozza. A leválasztás során igen nagy tisztaság az elvárt, hiszen apró szennyezések is megakadályozzák a rétegépülést kiváltó kémiai folyamatokat. A lassú rétegleválasztási sebesség önmagában is problémát jelent (Al2O3 leválasztási sebessége például akár 0,11 nm/ciklus is lehet[5]), tömeggyártásra ezért kevéssé alkalmas.[8]
Jegyzetek[szerkesztés]
- ↑ A hordozó a szaknyelvben gyakran használt kifejezés, mely esetünkben egyszerre kétféle dolgot is jelöl: hordozófelület (idegen szóval szubsztrátum) jelenti azt a felületet, mely végül a réteget hordozza majd, azaz amin a réteg kialakítása végbemegy. Ettől eltérő értelmű a hordozógáz és hordozófolyadék, mely az ALD egyes expozíciós lépésekben beeresztett gáz- vagy folyadékelegy azon részére utal, mely a rétegbe nem épül be, de segít az adszorbeálódó anyagok célba juttatásában.
- ↑ "How Atomic Layer Deposition Works" Applied Materials. https://www.youtube.com/watch?v=KOEsgZU1sts
- ↑ Physics and Chemistry of Interfaces, Third, Revised (2013)
- ↑ 2.3 Adsorption Kinetics - The Rate of Adsorption. www.chem.qmul.ac.uk
- ↑ a b Puurunen, Riikka L. (2005. június 15.). „Surface chemistry of atomic layer deposition: A case study for the trimethylaluminum/water process”. Journal of Applied Physics 97 (12), 121301. o. DOI:10.1063/1.1940727. ISSN 0021-8979.
- ↑ Juppo, M. "Atomic Layer Deposition of Metal and Transition Metal Nitride Thin Films and In-Situ Mass Spectrometry Studies" University of Helsinki Department of Chemistry, Laboratory of Inorganic Chemistry. Dec. 2001.
- ↑ a b (2010) „Atomic Layer Deposition: An Overview”. Chem. Rev. 110, 111–131. o. DOI:10.1021/cr900056b.
- ↑ Molecular Beam Epitaxy & Atomic Layer Deposition Systems - SVT Associates. www.svta.com
Fordítás[szerkesztés]
Ez a szócikk részben vagy egészben az Atomic layer deposition című angol Wikipédia-szócikk ezen változatának fordításán alapul. Az eredeti cikk szerkesztőit annak laptörténete sorolja fel. Ez a jelzés csupán a megfogalmazás eredetét és a szerzői jogokat jelzi, nem szolgál a cikkben szereplő információk forrásmegjelöléseként.
Források[szerkesztés]
Tananyagok, ismeretterjesztő weblapok[szerkesztés]
- Bevonatolás, atomi rétegleválasztás | Gépészeti szakismeretek 1. | Sulinet Tudásbázis. tudasbazis.sulinet.hu. (Hozzáférés: 2018. november 10.)
- Baji Zsófia, Mikula Gergő János (2013. 9). „Rétegépítés atomi pontossággal a mikro- és nanotechnológiában” (PDF). Fizikai Szemle. [2018. április 12-i dátummal az eredetiből archiválva]. (Hozzáférés: 2018. november 10.)
Szakkönyvek, szakcikkek[szerkesztés]
- George, Steven M. (2010. január 13.). „Atomic Layer Deposition: An Overview”. Chemical Reviews 110 (1), 111–131. o, Kiadó: American Chemical Society (ACS). DOI:10.1021/cr900056b. ISSN 0009-2665.


